AI人工智慧被视为第四次工业革命的核心,对于IC晶片的需求与日俱增。为了符合业界需求,IC封装走向高可靠性与高性能两种方向,各有不一样的设计与制造条件。然而,要满足多元应用环境的IC封装技术并不简单,需要具备轻重量、绝缘性能、抗震以及耐腐蚀性,以确保IC能够在复杂的环境中可靠运行。Moldex3D 2024推出业界领先的电子灌胶封装制程与IC封装解决方案,有效预防潜在缺陷,借由模拟优化达到最佳化设计,排除问题与不确定性。
为了确保行车安全,电动车上装有各种感测器以提供驾驶人最正确的车辆资讯与安全保障。然后车用的电子系统需要随时对抗恶劣的使用环境对抗,为了满足严格的产品标准,使用模流分析能够快速解决生产缺陷、加速上市时程。
Moldex3D推出业界首创的电子封灌制程仿真功能,利用方便的建模工具及设定接口来重现多样的制程设计,提供使用者更真实且详细的点胶头路径及给料的可视化,并利用完整的物理模型来模拟表面张力引发现象,实现更完善的电子封灌制程。
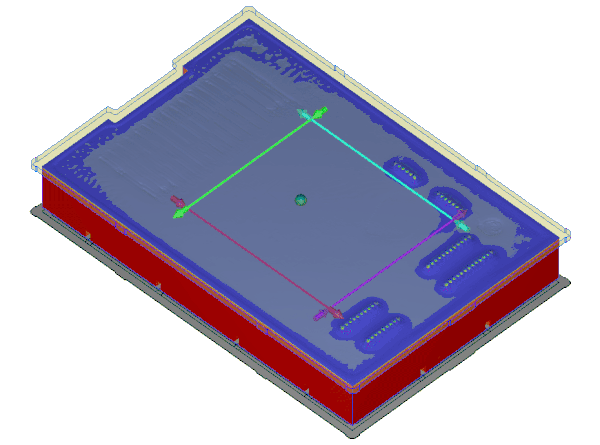
随着智慧化时代的到来,各种智能化装置持续诞生,来自于电动车的需求更是蓬勃发展,车用半导体已成为下一个世代的重要突破关键,随着芯片的需求逐渐增大,企业需要更快速、更低成本的生产流程来因应变化。
Moldex3D拥有世界顶尖的电子封装模拟功能,除了基本的流动充填与硬化过程模拟,也延伸到其他先进制程评估,现在更新增打线接合(Wire Bonding)制程模拟,后熟化制程也支援多模封装功能有助于使用者提升产品品质,更有效预防潜在缺陷,借由模拟优化达到最佳化设计,缩减制造成本和周期。









 苏公网安备 32059002002276号
苏公网安备 32059002002276号
